毫米波长范围(30-300GHz)内除了其较低端外,还没有很好地被利用。而在成像,安全,医疗,和短距离无线传输以及数据速率不断提高的光纤传输中的新应用可能会迅速地改变这种状态[1],[2]。在过去的三十年里,III-V 技术(GaAs 和InP)已经逐渐扩大到这个毫米波范围中。新近以来,由于工艺尺寸持续不断地减小,硅技术已经加入了这个“游戏”。
在本文中,按照半导体特性和器件要求,对可用于100-GHz 和100-Gb/s 应用的半导体有源器件进行了综述。随后介绍了使用最广泛的技术,接着是两个不同方面具有竞争性的技术现状:分频器,来说明该技术适宜用在高速数字电路中,以及振荡器,用来说明其在模拟电路应用中的性能。
材料和工艺的基本特性
半导体材料的特性
运行在很高频率下的电子器件所表现的性能主要与:1)组成半导体的材料特性和2)器件的结构有关[3]。Si,GaAs 和InP 是目前具有截止频率在300GHz 及以上的器件所选择的材料。在表1,人们给出了一些相关的表征能隙,载流子输运特性和导热性的参数。同样也报道了与InP,GaN 和InAs 晶格相匹配的InGaAs 的特性。
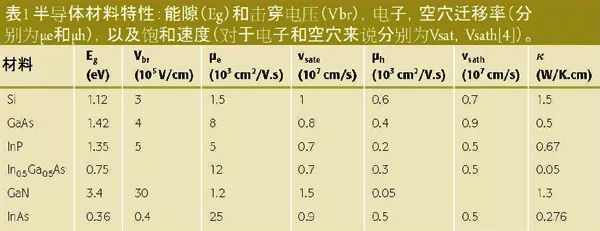
拥有一个足够大能隙(Eg>1eV )是很有利的,这是因为它可以提供好的击穿特性。Si,GaAs 和InP 在100nm 实际上可以承受几伏的电压水平;此外,p-n 结显示出很明晰的整流行为,室温下的泄漏电流可以忽略不计。采用GaN 可以获得更高的击穿电压,InAs 因为其能隙很低而只能用于电压很低的器件。
III-V 材料中的电子迁移率比硅的要大,这意味着在给定的掺杂浓度下,n-型接触区具有较低的串联电阻,而对于p-型 区来说,由于III-V 材料较低的空穴迁移率,情况则恰恰相反。然而,在器件的高场强区控制跨导和渡越时间的载流子速度与取决于载流子类型的饱和漂移速度相接近(Vsat 或Vsath′取决于载流子的类型;接近于10nm/ps)。由于暂态效应(电子从导带中的低能级,高迁移率能谷到达较高能级,较低迁移率能谷的转换不是瞬间发生的),电子的传输通常会受益于一些过冲量;例如,根据具有薄集电极的InP异质结双极性晶体管(HBT)的基极到集电极的渡越时间所推导出的有效速度大于3×107cm/s,大约是饱和速度的5 倍[5]。
甚高频率性能意味着较短的渡越时间和较低的RC寄生量;对于场效应管(FET)和双极性晶体管来说,这通常可以通过减小电子器件的尺寸和提高电流密度来实现(例如,见[6])。对于极高频器件和电路来说,热导率则成为一个重要的参数,硅在与其III-V 技术的对手相比时,其所具有的良好的导热性便成为一个真正的优势,因为这有可能达到更高的器件密度。
基于III-V 技术的早期单片微波集成电路(MMIC)的主要优点之一要归因于未掺杂(或补偿)基片的半绝缘特性,这是与其大的半导体能隙直接相关的(基片的电阻率为108Ω.cm 的数量级,而硅的电阻率为104Ω.cm)。这使得可以实现具有低关联寄生效应的电阻,电感和传输线。随着近来巨大的微波应用市场的开发(例如,移动电话网络),在硅基技术上引入无源器件这方面已经取得了很大的进展。此外,绝缘体加载硅基片技术(SOI)已经展示出其降低寄生效应的潜力(然而,这是以较低的基片导热率为代价的)。
服务于高频应用的FET 和双极性晶体管
今天,适用于高频应用的双极性晶体管和FET 是基于异质结结构的(除了是硅基MOSFET 以外)。对异质结的开发已经有40 多年了,并且在材料和晶格应力方面还在不断地发展着。两种不同材料(具有同样的晶体结构和同样的晶格参数)之间的异质结主要是由它们的能隙差异,以及由这种差异所区分的导带和价带的阶跃方式来表征的(表2)。在晶体管的有源区,异质结被用来达到两个不同的目的:

• 不论它们各自的掺杂浓度如何,保证双极性晶体管中从发射极向基极注入的是电子占主导地位的载流子• 在高电子迁移率晶体管(HEMT)中将电子局限在未掺杂的量子肼中。
虽然最初是针对晶格匹配异质结来实施的,但很快就显示出用在失配异质结中也可以增强性能,条件是应力结晶层是在假晶厚度的极限内(如果生长层足够薄,其晶格常数会调整到基片的晶格常数)。这种特性被用在HBT 中(例如渐变组分的方法,graded-composition)来生成具有短的渡越时间的基极层,以及高迁移率HEMT 的沟道层。在临界厚度以上,(失配程度越高,层厚就越薄),生长层松弛下来,在晶体结构中便会出现晶格脱位。这种现象仍然可以被用来在基片的顶部生成具有不同晶格参数的高质量晶体层,在中间有一个过渡层(缓冲层)来俘获大多数的脱位。例如,这种结构可以在被称为改性(metamorphic)HEMT 中找到,在松弛缓冲层之上又生长了一层高质量的活性异质结构。特别是,变性结构允许采用极高迁移率的InAs 沟道[7],[8]。
目前,可以预见几种服务于100-GHz 和100-Gb/s应用的技术:GaAs 和InP HEMT;InP 和SiGe HBT,这些技术在过去的十年中已经在使用之中了;以及硅CMOS 技术,从最近的一些情况来看,它似乎要发挥作用了。很有前景的技术如GaN HEMT 以及那些采用小能隙材料的技术同样可以进入这个“游戏”。到目前为止,由于GaN HEMT 非凡的微波和毫米波功率容量,人们已对其进行了开发[9]。此外,与晶体结构相关的压电效应所带来的高界面电子密度(大约1013cm-2)可以用来补偿相对较低的载流子迁移率,如果特定的结构设计可以产生低接触电阻的话,那么使其具有甚高频率性能似乎也是可行的[10]。
HBT 与FET 的差别
除了FET 是单极性器件以外(只有一种类型的载流子参与晶体管的运行,而一个双极性器件则意味着两种类型的载流子都参与运行),在双极性和FET 技术之间还可以观察到几种差别,特别是:
• HBT 器件具有指数性的驱动特性[就是说,集电极电流与输入电压之间的依赖关系是指数性的:icαexp(Vbe/kT)],而FET 器件的则是平方的关系[漏极电流随着电压的平方而变化的:idsαk(Vgs2)]。对于HEMT 来说,这种关系转化为具有较大分散性的门限电压。这便是为什么高速数字或混合信号集成电路(IC)通常采用HBT 技术进行设计的原因(但请记住CMOS 在数字集成电路芯片中的成功)。另一方面,HEMT 呈现出比双极晶体管较低的微波噪声(金属栅极电阻比半导体基极电阻要低)。
• HBT 晶体管是一个工作在很高电流密度下的垂直沟道器件(>100KA/m2,具有最高截止频率的HBT 的电流密度甚至>1MA/cm2)。由于其所具有的高相关热阻,HBT 的高功耗会削弱其固有的低门限电压分散性这个优点。
• 虽然截止频率可以是类似的(直到500GHz),微波双极晶体管通常是具有较低阻抗的器件,这是由较高的跨导和输入电容来表征的。这会产生一些后果,包括双极晶体管较低的负载灵敏度。
现有工艺
虽然一个设计人员可能不容易接触到不同的工艺,但还是存在一些为数不多的具有下列工艺的制造厂家:
• 45-,65-和90-nm CMOS• 130- nm HBT SiGe• 100- nm HEMT• 500- nm HBT InP。
对GaAs HEMT 的开发已经很长时间了,其栅极长度远远小于1μm;就较早的MESFET 技术而言,主要的技术变化是与更加复杂的异质外延结构相关的。类似地,III-V HBT 技术通过将低频GaAs 功率放大器用于手机之中而取得了商业上的成功。只需通过转换到InP 基的材料系统,这个技术便可踏入甚高频领域。
新近,由于晶体管尺寸持续不断地下降,硅工艺也同样登上了毫米波舞台。当SiGe HBT 技术被开发后,这种技术通过深亚毫米工艺被引入到Bi-CMOS 圆晶厂,很快便呈现出具有与它们所对应的III-V 技术相近的截止频率。今天,这两个技术主要的不同之处是:1)SiGe HBT 技术具有更成熟的工业环境(较高的电路复杂程度和扩展了CMOS 的环境),以及2)该工艺较低的集电极击穿电压。
当谈到应用时,决定哪种工艺最适合的主要因素可能是下面几点,各自的分量取决于应用情况。
1) 性能。这是一个关键因素,特别是对于那些要求具有最佳性能的应用来说。2) 目标规范。应用的规范要求可能会改变(随着标准的演变),对于新应用来说,具有一定程度的灵活性也许是必要的。3) 直流功耗。为了减少设备的尺寸以及移动终端的重量和功耗,低功耗是一个重要的因素。4) 门数。这是另一个重要方面,因为数字信号处理正在提高其在应用中的分量。5) 成本。很显然这是一个很重要的问题,并且适用于整个系统。而成本反过来则取决于所需的器件数量(市场容量):对于小的或中等数量(几千到几万件)来说,III-V 工艺可能比SiGe的成本要低;对于更大的数量,情况则可能相反。
成熟工艺的介绍及现状
基于GaAs 和InP 的P-HEMT和M-HEMT
最初,GaAs 晶体管是具有n- 型沟道的肖特基栅FET(MESFET),因为III-V 材料中电子的迁移率比空穴的迁移率大得多。会妨碍实现MOS 结构的表面很强的费米能级钉扎效应却有利于开发肖特基栅极。MESFET的性能通过提高沟道的掺杂浓度而逐渐改善;这是以电子迁移率(当掺杂浓度提高时,迁移率下降)和栅极泄漏电流为代价的。在1980 年所引入的HEMT 结构(见图1) 可以同时实现两种改善:1) 通过一个高迁移率沟道来提高沟道电流(产生一个高跨导),以及2)由于宽能隙势垒而改善了栅极泄漏。

图1、HEMT 异质结构的能带图展示了夹在半-绝缘(SI)基片和势垒层之间的窄能隙沟道。在这个图中,势垒层是δ 掺杂,这意味着将施主杂质引入到一个极薄层内。沟道中的电子在界面的量子肼中积累,界面导带偏移量(ΔEc)控制着表面密度ns。
自从HEMT 技术问世以来,人们已经引入了许多旨在改善性能(ns 和Vsate)的改进方案。两种主要的途径是:1)提高导带偏移,从而使得在界面量子肼内积累更多的电子,以及2)提高沟道的迁移率,实际上这意味着提高InGaAs 沟道中In 成分的含量(从常规的GaAsHEMT 的Xin=0%到最高速InP HEMT 中的Xin=80%)。
目前,正在GaAs 基片上开发两种类型的HEMT:
1) 具有一层AlGaAs 障碍层和一个应力InGaAs 沟道的主流GaAs P-HEMT(假晶HEMT)主要是用在20-70GHz 频率范围的低噪声或功率应用中[11]。2) 采用GaAs M-HEMT(改性HEMT)可以获得更高的速度,它基本上是一个在GaAs 基片的松弛缓冲层上生长一个晶格匹配的InP 结构(具有一个ALInAs/InGaAs 异质结结构)。这个结构得益于InP 基结构较高的速度和与较大,较脆GaAs 基片相关的低成本。虽然缓冲层的热导性相当差,但这个技术在100GHz 下仍然显示出出色的功率和噪声性能。
就最高运行速度和较高的输出功率而言,这些性能纪录还是由InP PM-HEMT 来创造的,它在90GHz 时超过400mW,并且在300GHz 超过2mW[14]。
InP HBT
连同采用与InP 基片晶格匹配的材料系统成功制成了器件的首篇报道一起,在90 年代后期,有关InP 异质结双极性晶体管(HBT)的工作正式迈入了轨道[15]。这个材料系统具有若干超出SiGe 和GaAs 的优势,包括:
1) InGaAs(晶格与InP 相匹配)材料中的迁移率和电子速度比GaAs 或SiGe 的更高。2) 与GaAs 相比具有较低的表面复合速率,从而具有较高的电流增益,导致其具有按比例缩小到较小尺寸的能力。3) 由于在基极中使用了窄能隙InGaAs,则具有比GaAs 较低的基极-发射极开启电压。4) 当InP 被用作集电极材料时,具有比SiGe 更高的击穿电场强度。5) 产品具有比其它任何Si 或III-V 材料更高的击穿电场/截止频率的乘积。6) 在InGaAs 基极和InGaAs 发射极覆盖层(Cap)的最大掺杂浓度较高,从而产生较低的寄生接触电阻值。7) 由于许多三价半导体材料的晶格与InP 的相匹配,从而具有一种增强的“用能隙来操纵”HBT 的能力。
这些年来,InP HBT 已经担负起最快速基准晶体管和电路性能的重任。近来,在Santa Barbara 和illinois 的研究小组已经报道了Ft 超过700GHz 的器件,以及Ft/Fmax 超过500GHz 的平衡器件[16],[17]。
SiGe HBT-BiCMOS;CMOS 和NMOS
在80 年代后期所开发的SiGe HBT 是采用成熟的硅技术来生产的。通过各种开发,包括在基极使用碳掺杂和基极自对准生长技术,器件已达到了出色的性能- 特别是,在Bi-CMOS 配置中的HBT 显示了高的Ft,Fmax(>300GHz)[19]。此外,由于具有很好的钝化结而获得了在混频器和振荡器中极为有用的出色的1/f 噪声性能。所有这些特性被用来制成了许多可以运行的芯片,例如在43GHz 光纤传输系统中的多用复用器(MUX)和多路分离器(DEMUX),高速模-数转换器[20],以及77GHz 频率的车用雷达芯片组,甚至可用于工作在100GHz 以上的收发机中[21]。
在过去的几年中,随着极短栅极工艺过程的采纳(现在是在45-90nm 的范围),人们已经报道了具有极高截止频率的n-沟道MOS 晶体管(ft>200GHz)[22]。这种与半导体国际技术发展蓝图相一致的结果,实际上是从前仅限于III-V HEMT(昂贵)的电子束加工工艺过程和许多正在发生的MOS 结构演变所产生的栅极长度减小的结果。正像HEMT 结构一样,通过较高的迁移率沟道(例如所获取的应变硅沟道)以及由所谓的高-K 电介质栅极所产生的具有合适的氧化层厚度与沟道的长度比值,使得性能得到了加强(由于SiO2 可以提供无与伦比的Si 钝化作用,它的相对介电常数-只有4 -在栅极长度,栅极厚度按比例减小时,就变得太低了)。

图2、在互连之前,发射极宽度为0.6μm 的InP DHBT 的显微照片。HBT 是采用三层台面(Triple-Mesa)自对准工艺制作的[18]。
受益于这种扩展的频率性能,在过去几年,人们已经在毫米波领域对MOS 技术的潜力进行了初步的评估[23]。高集成度和低成本(对于大量芯片)是我们对硅工艺感兴趣的主要原因。
III-V 器件:与CMOS的共同集成
为了同时获得两种技术领域的最佳优势,异质集成工艺是一个颇有前途的解决方案。为了将III-V 晶体管(实际上是InP 晶体管)和硅基CMOS 进行相近的集成,人们已经探索了不同的途径,特别是在DARPA 资助的COSMOS 项目中[24]。人们已经探索了若干种方法,从超级自对准(小于5μm)倒装芯片集成到一个完全彻底的单片失配外延技术。早期的结果非常鼓舞人心,在将InP 器件集成到CMOS 圆晶片之后,InP 器件的性能劣化并不明显,并且已经演示了一类具有大输出摆幅和小功耗的大增益-带宽的差分放大器(>100GHz)[25]。虽然没有直接的联系,但人们应当注意到,通过MOSFET技术中的高迁移率III -V 沟道层的研究而在沿着半导体国际技术路线发展蓝图道路上所取得的进展[26]。
从晶体管到电路
我们在上一节介绍了现有的用于有源器件的不同工艺的特性。这些器件是开启100-GHz 以上频率大门的关键,但这还不够。同样需要合适的方式将它们变为可运行的电路,这意味着传输线,无源器件和接地等特定领域的开发。由于这些因素,在将器件特性转换到应用领域时,某一种工艺可能比其它的都要好。
目前,人们已可以明确不同技术在特定方面的胜出,见表3。

这个表绘制了一幅演变现状的画面。在接下来的讨论中,将用两种不同类型的演示电路来对画面进行具体的说明。T.Swan,Y.Baeyens,和M.Meghelli 在文章中对特定的100-Gb/s 光波电路在该方面的进展进行了讨论[53]。
用静态分频器作为技术的衡量基准
用于数字电路的半导体工艺通常是用静态分频器的性能来作为衡量基准的。由于一个静态分频器使用的是可以在更复杂的时序电路中找到的触发器单元元件[36],因此这样一个电路的性能可以作为公认的数字集成电路工艺的质量因数。相同的触发器被用作分频器,判断电路,10/100-Gb/s 系统复用器的基本单元[37]。在使用类似基础元件的不同电路中,选择静态分频器的原因是因为它恰好是采用简单的测量设备最容易进行明确评估的电路,并且它可以给出这个技术所能达到的明确的性能上限。
图3 示出了从90 年代初期直到现在所报道的静态分频器的速度。数据显示出在过去几年中,即使在2000年高速光纤的市场崩溃之后,速度也是在稳定上升的。最近的进展中大部分是由DARPA 通过频率捷变数字合成发射机技术这个计划(TFAST)所资助的。注意,在InP HBT 技术上正持续不断获得最好的结果,SiGe HBT 紧随其后[38]。HEMT 或CMOS器件技术在最高频率方面没有那么强的竞争力,因为在FET 为基的器件中,需要大的器件尺寸才能达到必要的跨导要求。至今为止,所发表的静态分频器的最好结果是采用250-nm InP HBT 技术所达到的150GHz,最近的进展已经集中到降低功耗这方面了[39]。这个性能与全速率判断电路的性能是一致的,并且在多路复用器/多路分离器(MUX/DEMUX)电路中的性能还有很大的发展余地。

图3、静态频分器的最高频率随着报道年代而发生的变化。所示数据仅仅了包含了当时特定技术的最好结果。
在最高工作速度下,功耗是特别重要的,此时单个门电路会有几百毫瓦的功耗。虽然功耗随着分频器切换率的提高而迅速增长(例如,在87GHz时是23mW[41]),但CMOS 由于其出色的结果(输入频率范围是90-100GHz[40])而加入了竞争行列。所报道的最好的功耗是采用InP HBT 技术,在150GHz 时为42mW/每个锁存器[39]。
用振荡器(VCO)作为技术衡量基准
压控振荡器(VCO)是100Gb/s 串行应答器以及下毫米波通信,高分辨率雷达和成像系统所必不可少的构建模块。这样的振荡器要求将低相位噪声,高输出功率和好的直流-到-射频转换效率相结合,特别是在最高频率下。这便转换为许多重要的技术要求。
• 最高振荡频率(fmax)对于亚毫米波操作来说是很关键的;最高频率基频振荡器是基于纳米级别的InP 基HEMT。所报道的最高基频振荡器是已有十年历史的213-GHz InP HEMT 振荡器[42]。近来,采用35-nm栅极InP HEMT 技术具有Fmax 为600-GHz 的器件的fmax 的进一步改善使得基频振荡器可以达到346GHz[43] 。InPDHBT 最近也同样展示了在亚毫米波频率的基频振荡[44]。
• 为了获得振荡器好的近载波相位噪声性能,重要的是使用具有低闪烁噪声的技术。双极技术,如SiGe 或InP HBT 通常可以提供比诸如HEMT或CMOS 这类FET 更低的1/f 拐角频率,这要归功于表面状态影响的减少。在观察较大频率偏离处的相位噪声时(例如,距离载波1MHz-见图4),毫米波CMOS 振荡器所展示的相位噪声与它们所对应的SiGe 和InP HBT 器件的相接近。这个比较并未将调谐范围的影响考虑在内,而且还会受到曲解,即如文献[45]中所提到的,在没有输出缓冲时,振荡器毫米波频率相位噪声会更好一些。

图4、所报道的采用不同技术所实施的毫米波振荡器相位噪声概观(在偏离载波1-MHz 处)。
• 最后,振荡器在最高频率下可实现的输出功率便成了一个重要的设计参数,特别是当器件工作在接近其fmax 时,这是因为,此时要进一步放大输出信号会变得格外困难。为了让输出功率达到最大,振荡器内部电压的摆幅需要达到最大。大多数III-V 器件,如InP HBT 就击穿电压而言具有不折不扣的优势,尤其是当其与CMOS 相比较时。这样便可以产生所报道的较高的输出功率。
100GHz 以上的高效率高功率源推-推振荡器
为了在100GHz 以上达到较高的振荡器输出功率,设计者们更倾向于推-推振荡器拓扑结构,在这个结构中,两个以相反相位相耦合的振荡器的输出合成到一起来产生一个具有强二阶谐波的输出信号。这个拓扑结构使得可以在现有有源器件技术上实现高于fmax 的信号源,并且可以将现有高-Q 值谐振器技术的频率范围扩展[46]。此外,采用推-推拓扑结构,可以使用工作在基频而不是二阶谐波输出频率的静态或动态分频器来将相位锁相环(PLL)的振荡器锁定,以实现频率锁定信号源,从而将分频器的速度要求降低了一半。
毫米波频率的推-推振荡器的潜力已经得到了充分的展示。用不同的化合物半导体技术所实现的推-推振荡器已经在文献中有所报道:在[47]中报道了直到140GHz 的0.13μmGaAs PHEMT 振荡器,和在[48]中所报道的可以直到278GHz 的SiGe HBT 振荡器。即使是采用CMOS 技术也成功地实现了100GHz以上的信号源:人们已经报道了一个采用130-nmCMOS 技术的192GHz 推-推振荡器[49]。最近,采用45-nm CMOS 技术构建了一台工作在410GHz 的信号源[50]。然而,即使是采用推-推拓扑结构,由于硅基高速技术降低了的击穿电压以及纳米级CMOS 需要在低偏置电压下工作,在100GHz 以上可以观察到CMOS 推-推振荡器明显降低了的输出功率。例如,410-GHzCMOS 信号源具有20nW的输出功率,这可能不足以用在发射机应用中或驱动接收机的混频器中。正如在下列段落中所说明的,具有如此高功率的推-推振荡器的理想选择是InP 双-异质结HBT(D-HBT)技术,它将高的fmax 和高的击穿电压结合在一起。
振荡频率在220 和355GHz 的集成推-推振荡器是由Alcatel-Lucent/Bell- 实验室的0.5μm 发射极InGaAs/InP HBT D-HBT 技术来实现的,具有的最大振荡频率为335GHz 和4V 的击穿电压(Vbceo)[51]。
这些振荡器是基于一种平衡Colpitts 振荡器拓扑结构的。通过将相位相反的输出进行合成,并且使用短路截线(short stub)通过电抗部分在二阶谐波频率上来调节振荡器输出阻抗使其产生一个很强的二阶谐波信号[52],如图5 所示。人们已经采用这个技术实现了不同的谐振器。图5 展示一个287GHz 的电路布局图。传输线谐振器LE,LB 和LC 是在7-μm 低-K 层间介电材料(εr=2.6)之上采用一个2-μm 厚的金板接地面通过薄膜微带线来实现的。
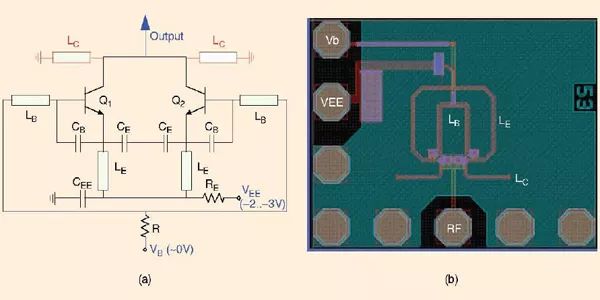
图5、一台InP D-HBT 推-推振荡器的(a)电路图和(b)电路布局图[52]。
不同振荡器的输出信号是采用一个WR03 波导探头来探测的,并且使用WR03 次谐波混频器进行下变频的。在210GHz 和235GHz 所测得的输出功率可达1mW,直流-到-射频的效率为2-3%。工作在280 和297GHz 的振荡器可以获得-5dBm 的输出功率。图6 展示了所实现的最高频率振荡器所测得的输出频谱。虽然输出超过了WR03 波导(LO)在片探头和下变频混频器的频段范围,在将振荡器信号与321.6GHz 的有效本振频率相混频时,仍然会探测到很强的IF 信号。通过对探头和混频器损耗进行校正,损耗值估计在23dB 与30dB 之间,在355GHz 上可以获得高于-13dBm的输出功率。

图6、一个工作在355GHz 的InP D-HBT 推-推VCO 的下变频频谱(LO=321.6GHz,上边带)(未对混频器的损耗进行任何修正)。
这些振荡器的输出功率与振荡频率的关系展示在图7 中,并且将其与不同的半导体技术所制作的振荡器进行了比较。多亏了InP D-HBT 的高击穿电压,以及可以将输出功率改善5dB 的二阶谐波调谐技术,截止目前为止,InP D-HBT 推-推振荡器可以在该频段范围内具有比所报道的其它晶体管信号源更高的输出功率和效率。

图7、所报道的采用不同技术所实施的振荡器的输出功率和工作频率的概观。采用基频和推-推振荡器的结果分别用空心和实心符号来表示。
结论
若干种半导体材料和技术都适合用来解决100GHz 和100-Gb/s 的应用问题。这些技术有时候会相互竞争,正如我们所预期的,这是一个新的应用领域,人们仍然在对这些技术各自的优点和缺点进行着讨论。本文旨在说明随着频率性能的不断提高,这些演进技术的多样性和其潜在的影响。尽管长期以来,器件性能的改善仅仅依赖于光刻技术进步所允许的尺寸的减小,然而异质结构和应力工程技术现在已成为强有力的手段,通过它们可以增强速度和功率性能,使之达到能够打开100-GHz 和100-Gb/s 应用领域之门的水平。


 返回顶部
返回顶部 刷新页面
刷新页面 下到页底
下到页底